

在現代電子裝聯工藝中,電子組裝焊接使用的是以錫基為主的軟釬料,通過熔融的釬料合金與被焊金屬表面之間生成金屬間化合物(IMC),從而實現被焊接金屬之間的電氣和機械連接。而這個過程經過了表面潤濕、原子間擴散、溶解、冶金結合,涉及到物理學、化學、冶金學、材料學等多門學科,是一個種復雜的化學反應,而能否形成合適的金屬間化合物(IMC)是良好焊點形成的標志。
焊點質量的判定,業內通常采用IPC的外觀檢驗標準,特別是量化指標“接觸角”,但僅是通過焊點的外觀判定顯然是不完善的,還需觀察焊點的微觀形貌,金屬學基本原理指出,焊點的顯微結構決定其性能。下述這個切片實例就可以說明,從外觀上判定焊點外觀形貌良好,接觸角小于90度,按IPC的標準判定是合格的,但我們對該焊點做切片后觀察金相形貌時發現,該焊點根本沒有形成金屬間化合物(IMC),沒有達到焊接的目的,牢固的連接起兩個被焊接物,這個焊點是不良的。

金屬間化合物定義
金屬間化合物(IMC)是指兩個或更多的金屬組元按比例組成的具有金屬基本特性和不同于其組元的長程有序晶體結構的化合物。簡單的講就是由金屬元素按各種原子量比以化學結合方式結合在一起的化合物。
要得到良好的焊接效果,焊料和母材必須發生形成牢固結合的冶金反應,在界面處形成合金層,即金屬間化合物(IMC),而IMC的形成與否及質量好壞,對焊點的機械、電氣性能有著關鍵性影響。
焊點內部構造
以下是焊點內部構造的金相圖,可以觀察到焊點的微觀形貌,如圖1所展示:
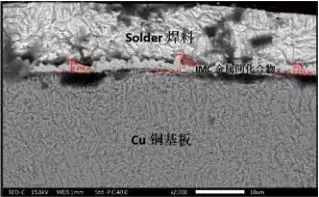
圖1 焊點內部構造圖
從內部構造看,金屬間化合物(IMC)是連接兩種材料的關鍵,起著持久牢固的機械和電氣連接目的,沒有生成或者沒有形成良性的金屬間化合物(IMC)對一個焊點來說是災難性的。
焊料與母材形成的金屬間化合物
不同母材和焊料所形成的化合物是不同的,以下是電子裝聯業主要使用金屬與焊料合金元素生成的金屬間化合物(IMC),具體如下表,本文主要討論裝聯時常見的Sn-Cu界面與Sn-Ni界面所生成的合金層。

金屬間化合物(IMC)一般是既硬又脆的,厚度越厚反而其焊點強度越差,圖2就是金屬間化合物厚度與抗拉強度的關系。

圖2 金屬間化合物厚度與強度的關系
金屬間化合物(IMC)的生長規律
金屬間化合物的生長厚度取決于許多因素,但主要服從于Fick擴散定律,IMC厚度L與擴散常數D和受熱時間t的平方根成正比關系,而擴散常數D又與絕對溫度T成正比的指數函數關系,因此,為了抑制IMC的過快生長,控制好焊接溫度不能過高,加熱時間不能過長是非常重要的,IMC厚度L隨溫度和時間的演變如下:
L=√Dt(1)
D =D0exp(-Q/RT)(2)
電子裝聯焊接和服役過程中,焊料與母材Cu等金屬交互作用導致了金屬間化合物的形成與生長,一般認為,焊接過程中IMC的形成是界面化學反應為主導的機制,服役過程中IMC是元素擴散為主導的機制。
金屬間化合物(IMC)的評價
什么樣的金屬間化合物(IMC)是我們所追求的呢,業內比較公認的說法是,焊接后焊點界面長出合金層IMC,且長得平坦、均勻、連續即可,具體來說,主要用以下3點來評價。
厚度均勻
金屬間化合物(IMC)首先要考慮的是其厚度,因為IMC厚度多少將直接決定焊點強度的大小。
IMC厚度典型值
針對IMC厚度,電裝業內沒有具體的標準。德國ERSA研究所的研究表明,生成的金屬間化合物厚度在4um以下時,對焊點強度影響不大。日本學者管沼克昭從可靠性觀點出發,歸納出理想界面的質量模型(圖3),認為IMC厚度應小于5um。理論界雖說法不一,但現在業內比較認可的觀點是,IMC的平均厚度在1~4um,且最低值不低于0.5um是比較良性的合金層。太薄的合金層(<0.5um)焊點可能呈冷焊狀,強度不足,而太厚時(>4um)結構疏松,合金層硬度增加,失去彈性發脆,強度變小。
IMC厚度會根據Sn基焊料結合的金屬界面不同有所不同,根據業內實踐數據,常見Sn-Cu和Sn-Ni的合金層的最宜厚度如下:
① Sn-Cu合金層的厚度控制在1~4um;
② Sn-Ni合金層的厚度控制在1~2um。
這兩種IMC合金層存在差異的原因主要是擴散能的差異所致,Sn對Cu的擴散活化能為45Kcal/mol,而Sn對Ni的擴散活化能為65.5Kcal/mol。
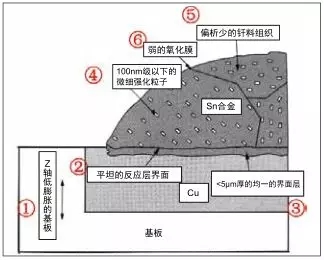
圖3 理想焊點質量模型
IMC厚度測量
IMC厚度測量理論上采取等間距的測試方法,一張圖上取5~6個點,最后取中位值或者平均值,但業內一般取3點,最大值、中間值和最小值,再做算數平均數,具體如下表所示。
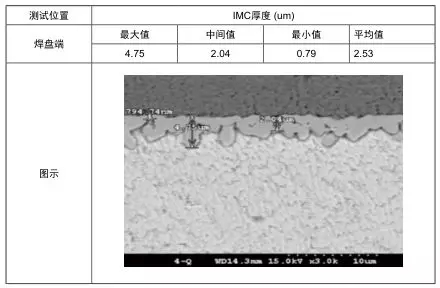
形貌良好
只是測試IMC的厚度是不夠的,下面的這個案例就可以說明問題。樣品1與樣品2都為Sn-Cu界面,兩個界面所形成的合金層的厚度值近似,都符合典型值要求,但兩者的形貌卻差異很大,樣品1平坦、連續、均勻,而樣品2的合金層明顯斷開,不連續,這種合金層的可靠性是得不到保證的。
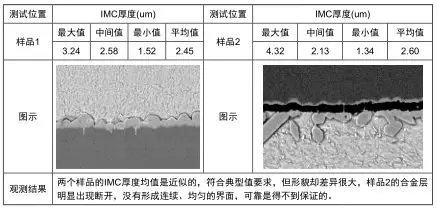
良性的IMC的形貌是成扇貝狀,連續、均勻的界面,但隨著焊接溫度、時間及擴散的增加,IMC加速生長,形貌從最初的扇貝狀轉變成屋脊狀,最終形成惡性的棱鏡狀,其所承受的內應力在增加,機械強度在弱化,變化過程如下所示。
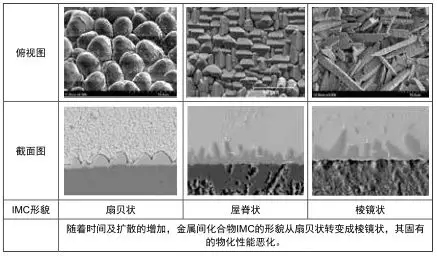
金屬間化合物形貌粗化后,特別是形成棱鏡狀后所受應力增加,更容易出現應力集中,圖5就是粗化后合金層應力分布。

圖4 金屬間化合物粗化
結構成分合適
金屬間化合物的厚度與溫度和時間的平方根成線性增長,界面間的持續擴散不僅會導致IMC厚度的增加,而且會導致 IMC結構與成分的變化,而這樣的IMC層,從厚度及形貌判定可能是良好,但是其結構成分已由良性轉向了惡性,這一點是需要引起注意的,下表就是Sn-Cu與Sn-Ni界面合金層隨時間推移,其結構與成分發生變化的過程。
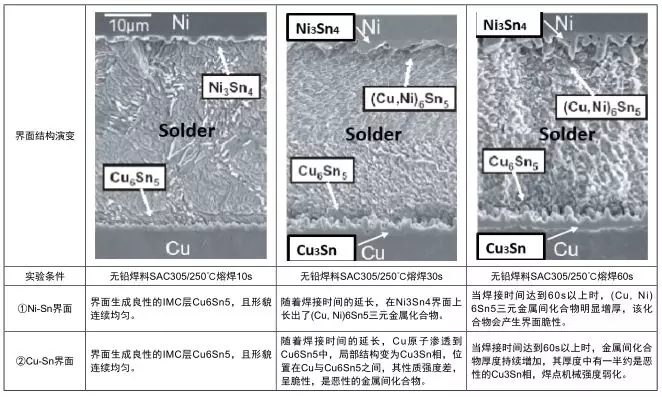
IMC合金層成分的確定,工業上用金相、電鏡、能譜,根據金相形貌,元素比例就可以判斷了。更準確用于科學研究的方法可以用TEM、XRD和EBSD等方法,但制樣會比較困難,一般用的比較少。
金屬間化合物的控制思路
是否生成合適的金屬間化合物是判定一個焊點是否良好的標志,也是焊點是否可靠性的標志。在焊接過程中必須要生成這一物質,但又不能太厚,要得到合適的IMC必須從其擴散機理出發,理解IMC層固有的性質,從焊接工藝、焊料成分、焊接母材、生產管控等維度出發給控制思路。
焊接工藝控制
根據金屬間化合物的生長規律可知,IMC生成是與時間與溫度密切相關的,而焊接過程中的熱輸入的多少將直接影響到IMC的最終形貌,所以通過優化焊接工藝參數(爐溫曲線等)將可以得到我們所需要的良性IMC合金層,下圖是HASL板不同次數過爐后IMC厚度變化圖,從圖上可以明顯看出,熱輸入越多,厚度成線性增長。
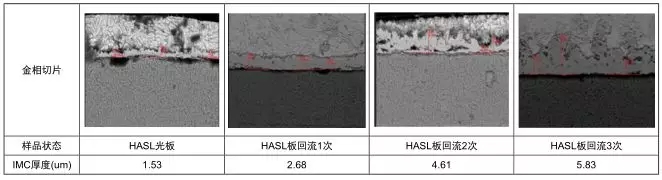
但需要注意不適當的熱輸入,會造成偏析、富集的出現,如熱輸入過少,造成AuSn4的游離式化合物的富集,而熱輸入過多,會出現Pb、P元素的富集,具體見下表。
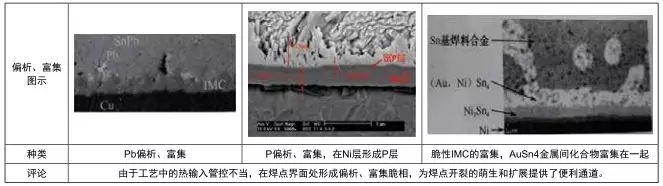
焊料合金成分選擇
錫基焊料中,錫含量越高,在同樣參數條件下,其生成的IMC合金層越厚(如圖5),在無鉛高錫焊接條件下,由于焊接溫度的提升,焊接時間的加長,所以注定無鉛焊接的IMC厚度是要高于有鉛焊接。

圖5 不同錫含量的焊料生長圖
為了抑制IMC的過快生長,我們可以改變焊料的合金成分去實現,其中比較典型的例子就是HASL板上常使用的日秀的SN100CL焊料。這款焊料是在SnCu系焊料的基礎上增加了Ni、Ge,其中Ni的參與,會遏制IMC的生長,機理是會生產(Cu,Ni)6Sn5的合金層,該合金層為六方晶體,相比Cu6Sn5的六方體及劣質的Cu3Sn更致密,合金更穩定,有助于一種抑制合金生長,更有利于焊接。
焊料母材及鍍層
焊接母材及可焊性鍍層不同,在同樣工藝條件下所生成的IMC厚會差異很大,Sn-Cu界面與Sn-Ni界面所形成IMC就是很好的證明。
① 對Sn3.5Ag焊料,在OSP、ENIG兩種不同的涂覆工藝下所形成的IMC厚度差異比值為:IMC(OSP)/IMC(ENIG)=2.75
② 對SAC405焊料,在OSP、ENIG兩種不同的涂覆工藝下所形成的IMC厚度差異比值為:IMC(OSP)/IMC(ENIG)=2.33
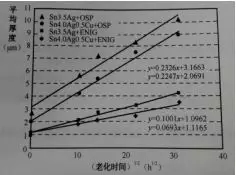
圖6不同母材鍍層對IMC厚度的影響
生產返修管控
焊點的返修會在不同程度上降低產品的可靠性,根據工廠內部功能失效產品的數據統計,其中焊點造成的產品失效品有60%以上是修理過的焊點,特別是返工工藝評估不到位時尤甚,所以強烈建議若焊點滿足IPC的外觀標準要求,即便有些瑕疵也不要盲目的返修,不修理會可能會比修理的可靠性更好。返修焊點后會產生熱輸入,會增加IMC層的厚度,而厚度的增加會降低其強度,同時在返修過程中可能會出現其它位預計到的風險,所以返修前必須謹慎評估。
結束語
IMC的形成良好與否是判定一個焊點好壞的關鍵,也是影響焊點質量的關鍵因素。本文作者根據自身的實踐經驗以及業內同仁的觀點做了整理總結,分享了IMC的產生機理、評價方法及控制其生長的思路,希望大家能有所收獲。IMC形成與生長其實是一很復雜的過程,涉及到多個學科,希望有更多的研究人員對其做更進一步的理論研究,解開那些未解之謎,為電子產品焊接質量的提升做出貢獻。
深圳市福躍達電子科技有限公司
聯系人:周玉
電話:13828893597
座機:0755-29819639
傳真:0755-29672986
地址:廣東省深圳市龍華大浪街道高峰社區華榮路33號億康商務大廈A棟8058
